2023年3月20日
次世代半導体パッケージ向け“TGVガラスコア基板”を開発
ファインピッチ・大面積を実現し半導体の高性能化に貢献
大日本印刷株式会社(本社:東京 代表取締役社長:北島義斉 以下:DNP)は、次世代半導体パッケージに向けた“TGV(Through Glass Via : ガラス貫通電極)ガラスコア基板”を開発しました。FC-BGA(Flip Chip-Ball Grid Array)など従来の樹脂基板をガラス基板に置き換える製品であり、高密度なTGVによって従来技術よりも高性能な半導体パッケージの提供が可能になります。またパネルの製造プロセスを適応することにより高効率・大面積化にも対応します。
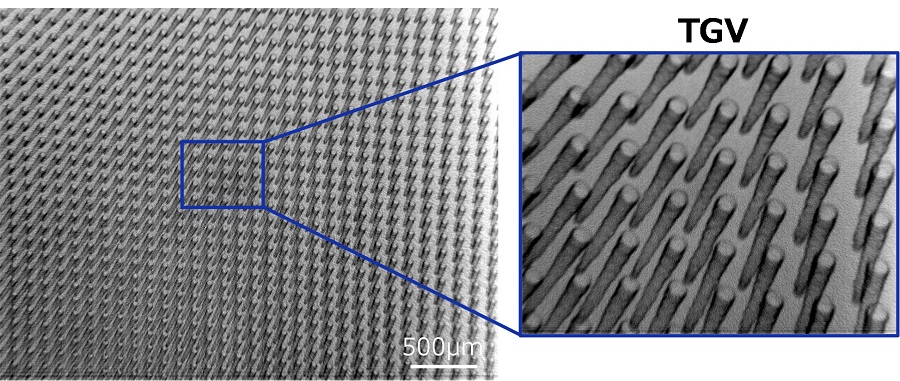
開発したガラスコア基板の貫通電極(TGV) X線画像
【開発の背景】
デジタルトランスフォーメーション(DX)の進展に伴い飛躍的にデータ流通量が増大し、社会インフラを支える半導体のさらなる性能向上と高い信頼性が求められています。そのため、機能の異なる複数の半導体チップを1つの基板上に高密度で実装し、処理速度を向上させる次世代半導体パッケージが注目されています。しかし、GIP (Glass Interposer)などパッケージの中継基板「インターポーザ」*1の電極形成技術において、極めて狭く配線するファインピッチ化や、パッケージの大面積化などが難しいという課題がありました。
こうした課題に対してDNPは今回、半導体パッケージの基材としてガラスに着目し、ファインピッチに対応した高アスペクト比(ガラスの厚みを貫通孔径で割った比率)の微細な貫通電極を形成したガラスコア基板を開発しました。
*1 DNPのインターポーザ → https://www.dnp.co.jp/news/detail/10161685_1587.html

ガラスコア基板が使用される箇所
【DNPが開発したガラスコア基板の特長】
1.ファインピッチと高信頼性を実現
今回DNPが開発したガラスコア基板は、ガラスの表裏に形成された微細な金属配線を電気的に接続するために必要なTGVを有し、貫通孔の側壁に金属層を密着させた「コンフォーマルタイプ」です。DNPが開発した新工法により、従来は困難であったガラスと金属の密着性を高め、ファインピッチ化と高い信頼性を実現しました。
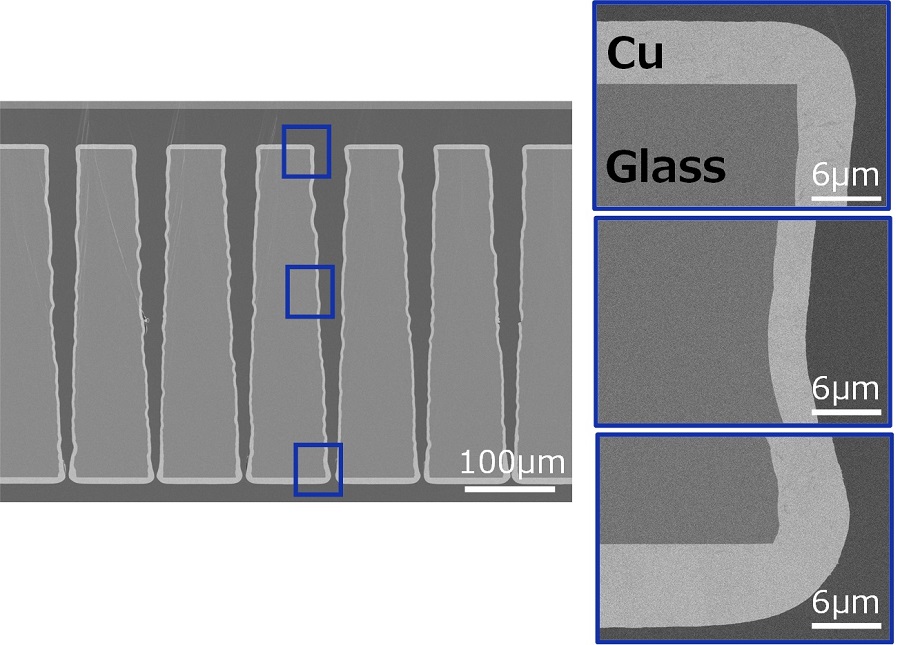
ガラスコア基板の断面画像。ガラスに密着した金属層(Cu:銅)がわかる
2.高いアスペクト比と大面積を実現
限られた面積で大容量の信号伝送を行うには、アスペクト比が高い貫通電極が求められます。今回開発したガラスコア基板のアスペクト比は9以上であり、微細配線形成に十分な密着性を有しています。また、使用するガラスコア基板の板厚に制限が少ないことから、反り、剛性・平たん性について設計自由度が高まるとともに、パネルの製造プロセスの採用によりパッケージの大型化にも対応可能です。
【今後の展開】
DNPは、すでに開発済みのガラス貫通孔に銅を充填する「充填タイプ」に加えて、今回開発した「コンフォーマルタイプ」のガラスコア基板についてもパネルサイズ510×515mmへのスケールアップを進め、2027年度に50億円の売り上げを目指します。
DNPは、印刷プロセスを応用・発展させたコアテクノロジー「微細加工技術」を活用して、半導体用フォトマスクやMEMS(微小電子機械システム)ファウンドリーサービスなどを展開してきました。今回、これらの事業を通じて培った独自のパネルの製造プロセス技術や大面積のガラスを扱うハンドリング技術などを応用してガラスコア基板を開発しました。今後、これらの電子部品に、情報セキュリティなどITの強みを掛け合わせるなど、「P&I」(印刷と情報)の強みを活かし、快適な情報社会を支えるソリューションを提供していきます。
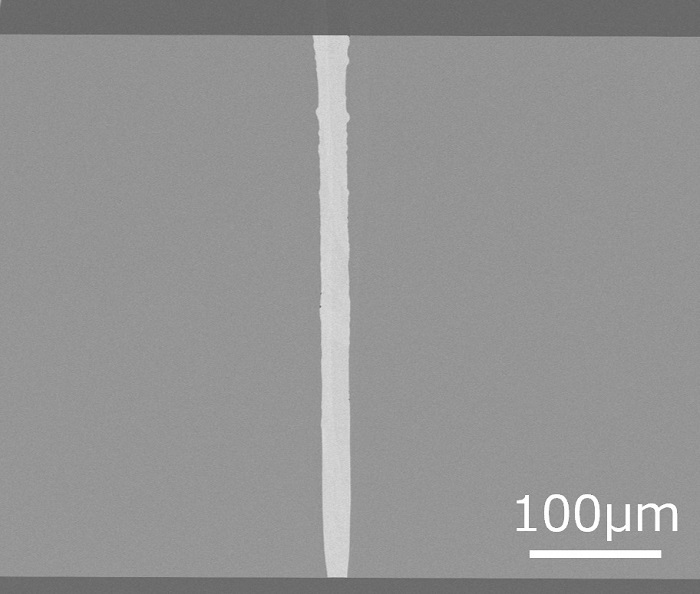
充填タイプのガラス断面画像
※記載されている会社名・商品名は、各社の商標または登録商標です。
※記載された製品の仕様、サービス内容などは発表日現在のものです。その後予告なしに変更されることがありますので、あらかじめご了承ください。
- X(旧Twitter)にポスト(別ウインドウで開く)
- メール
- URLをコピー
- 印刷
